SETIHO丨新鮮資訊搶先看之底部填充膠
2023-10-19 09:13
在電子封裝過程中,電子元器件是由不同線膨脹系數的材料組成。在熱循環下,由于膨脹尺度不同會產生熱應力差,進而產生相對位移,導致整個元件失效,而底部填充是避免此現象產生的有效方式。
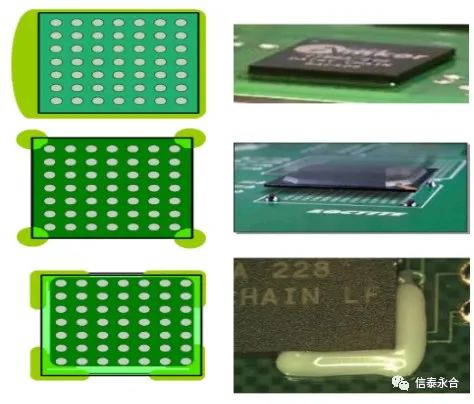
底部填充膠在封裝時滲入到芯片、焊柱和基板之間形成可靠粘接,分散芯片在受到機械作用和熱循環作用時其焊點處所受的應力,避免開焊和不良焊點的產生。此外,底部填充膠還可以起到保護焊點免受濕氣、離子污染物等周圍環境影響的作用。
底部填充膠SE8125是專為球柵陣列封裝(BGA)和芯片級封裝(CSP)芯片而開發的可返修單組分環氧樹脂類填充膠,鹵素含量低。
具有低粘度、高流動性特點,25℃下,SE8125粘度低至400cps,可快速通過例如25微米的較小間隙。可在中溫130℃下10min快速固化,從而降低在固化過程中對元件產生的應力。SE8125具有120℃的玻璃化轉變溫度,耐溫性好,粘接強度高,可為焊點提供非常優異的機械補強。
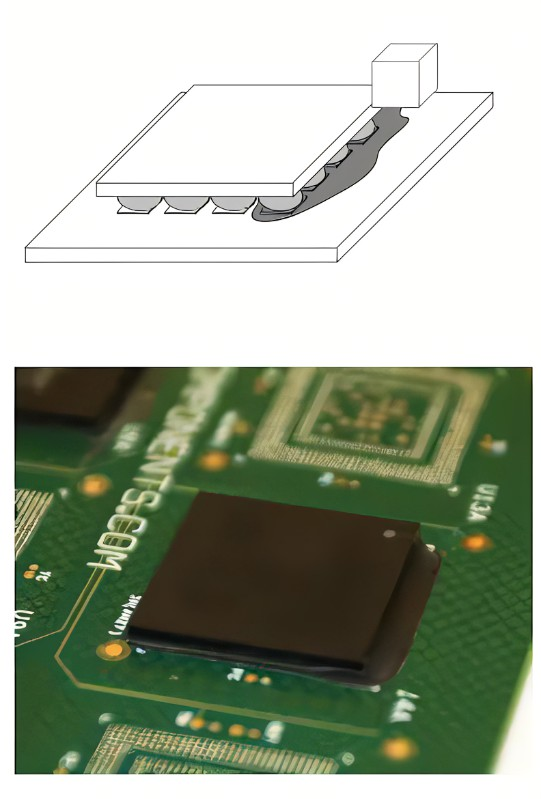

底部填充膠SE8130 是專為汽車電子BGA、CSP芯片底部填充應用而開發的單組分環氧樹脂類填充膠。
具有低收縮率、低熱膨脹系數、高耐溫、低透水率的特點。25℃下,SE8130粘度僅為6,000cps,流動性好。150℃15min固化后,可以在芯片底部形成均勻的無空洞的填充層,出色地分散焊點附近的應力。同時SE8130的玻璃化溫度高達160℃,能**程度地提高器件的耐溫表現,大幅度提高BGA、CSP的熱循環性能和抗跌落性能。